半导体迈入新制程对超薄晶圆需求高涨,但超薄芯片也带来制造过程的大挑战。不过,半导体材料供应商,已开始针对这些挑战,提出解决之道。
随着半导体制程节点越来越先进,如刚推出的新一代iPhone处理器采用10纳米(nm)制程的同时,台积电(TSMC)、三星(Samsung)…等已着手布局7纳米制程。半导体迈入新制程对于超薄晶圆需求高涨,但超薄芯片也带来制造过程的大挑战,不过,半导体材料供应商,已开始针对这些挑战,提出解决之道。
Brewer Science半导体制造副技术长James E. Lamb表示,半导体朝先进制程迈进的目的不外乎是体积变小、功耗降低、效能提高及产热更少…等,但要实现这些目标需要采用可达到异质整合的先进3D堆叠封装技术。这时候晶圆的厚度就得越来越薄,才能在多层堆叠时,不会使芯片总体厚度无限上纲,影响到IC总体厚度,也因此,超薄晶圆元时代已经来临。
不过,超薄晶圆也为后段制程带来挑战。Lamb指出,其实,无论是晶圆或是面板级的扇出型封装(FO)架构,都着重在3D系统级封装和异质整合,而两者都需要在相同的封装中容纳更多的晶粒,这将使得超薄晶圆易于弯曲,势必得在底部加上基板支撑,才能让超薄晶圆安然“撑过”所有的制程阶段。也因此,半导体组装及测试(OSTA)公司开始对雷射分离剥离法产生兴趣,看准此趋势,Brewer Science推出新一代专为雷射分离设计的剥离材料。
Brewer Science最新的剥离材料只需要在室温即可黏合晶圆与基板,也可以在室温下剥离。Lamb进一步说明,新材料为High-T热塑性和可固化材料,具备可耐350度高温、黏着性佳,以及易于剥离等特性,可以协助业者在面对超薄晶圆时,可以减少因制程过程时或是剥离晶圆与基板时,而造成的晶圆破损。
另一方面,先进制程除了对超薄晶圆的需求看涨外,极紫外线(EUV)微影与定向自组装(DSA) 制程技术也开始受到重视。Lamb强调,虽然EUV现在成本仍高,正在发展初期,但该技术对于半导体制程的贡献不仅只在缩小IC尺寸,而是在设计与布局的第一步有很大的作用。
DSA则是辅助EUV微影模式的转变,其最大的特色是无需额外光照即可达到30纳米特征尺寸,此技术虽然也还在发展阶段,不过,整合元件制造(IDM)与代工业者的目标是在2年内准备好进行生产。
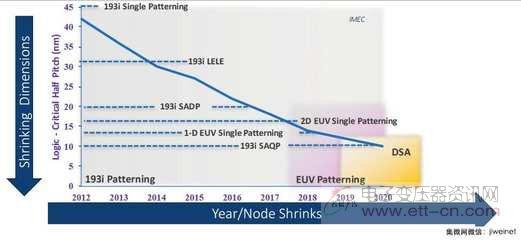

(敬请关注微信号:dzbyqzx)