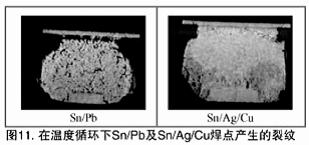
在更近一些的论文“SnAgCu焊点中累积的蠕变应力及能量密度引起的热疲劳寿命预测模型”中,作者海曼进一步强调了这个问题,图12指出一个典型的缺陷焊点的横切面,裂纹非常靠近封装一侧的金属间化合物。
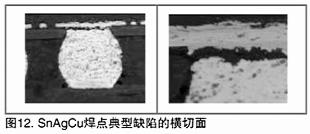
总之,CTE不匹配的问题以及考虑到面阵列封装角上的焊点具有更大的应力这个事实,清楚地表明了FC及CSP元件的无铅焊工艺将面临焊球顶剥离的更大危险,在PCB设计及生产阶段必须加以关注。然而,为了发现这一致命的缺陷,最重要的是必须执行产品的首件检查程序,否则将为现场失效而付出昂贵的代价。
检查设备必须非破坏性的发现这种缺陷
面阵列封装特别是FC及CSP对检查设备提出了极大的挑战,为了弄清和纠正工艺或材料问题做横切面,可以提供必要的失效分析资料,但十分昂贵而且是一种破坏性的方法,不适用于所有的电路板。10年以来,面阵列封装已成为选用表面安装元件的主流,制造商使用连线的或非连线的X光设备作非破坏性的检查,X光技术在发现焊点中的空洞、位置偏差、开路及短路等典型问题是很有效的,这一技术在放大倍数和分辨率方面在不断提高它的能力。然而,有三个因素用这种技术有时会受到限制:
1. 图像数据的正确解释。
2. 像微裂纹形状的剥离缺陷细节的观察能力。
3. 设备的昂贵购置费用。
在本文中讨论过的无铅F C 及CSP焊球顶部剥离的问题,甚至用最好的3DX设备也很难检查出来。
自1999年BGA人工光学检查设备进入市场以来,已成为离线X光设备的一种补充。但这种光学系统只能检查外形低矮的uBGA、FC、CSP焊点底部的焊球剥离,即现有的BGA光学检查系统还不能检查FC及CSP焊球顶部剥离缺陷。
最近设计的FlipChip光学检查系统具有更大的视觉检查缺陷的范围,用来代替破坏性的检查方法是极具成本效益的。
最新设计的FC光学检查镜头已改进了对外形低矮的CSP及FC焊点的检查能力,原先的BGA光学检查镜头光圈中心离PCB表面的距离约0.3mm,而FlipChip元件的高度或缝隙高度只有0.05mm,所以只能“向下看图像”,见图13。最新设计的Flip Chip光学检查镜头的光圈中心离PCB表面高度仅为0.015mm左右,这意味着能“向上看了,”见图14。可以看到FC及CSP焊球顶部的焊缝,能检查FlipChip焊球顶部的剥离缺陷,在以前市场上的BGA光学检查系统是无法做到的。