中兴通讯股份有限公司 贾忠中
摘要:随着电子元器件封装的微型化以及组装的高密度化和无铅化,SMT呈现了一些新的特点——要求重视工艺设计、关注焊膏选型、准确贴片、精细地调整温度曲线。本文将对这些特点作简单的阐述,供同行参考。
电子设备轻薄短小化的需求不断推动着电子封装技术和组装技术向着“更高密度、更精细尺寸”的方向发展;而电子元器件封装的微型化和PCBA组装的高密度化以及无铅化,使得SMT呈现了一些新的特点,需要加以认识和关注。
元件引线越细小,越需要重视工艺设计
元件引线变细、间距变小,不仅封装难度增加了,同时组装的难度也增加了。高密度的封装给组装工艺带来的直接结果就是焊盘间距与尺寸变小,从而引发更严重的开焊、连锡和虚焊。特别是随着0.4mm间距QFP和0.5mm间 距CSP的广泛应用以及无铅工艺的引入,这些问题越来越严重,如0.4mm间距QFP的连锡和0.5mm间距CSP球窝(Head & Pillow)已经成为令工程师头疼的问题。
实践证明,这些问题在很大程度上取决于工艺的设计——焊盘的设计、阻焊层的设计以及钢网的设计,特别是三者的匹配。元器件的封装密度越大,工艺设计对焊接质量的影响也越大,见图1所示。
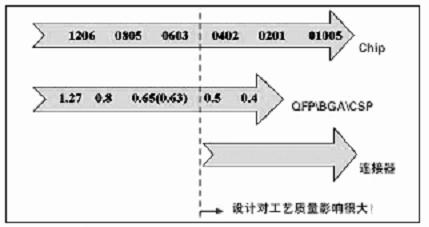
图1:元器件封装尺寸对焊接质量的影响
0603尺寸以上元件或0.5mm以上间距QFP的工艺设计,对焊接质量的影响不是很大,一般按照IPC的标准就可以了;但是,在焊接0603尺寸以下元件或0.5mm以下间距的QFP时,就必须考虑焊盘的设计、阻焊层的设计以及对应钢网的设计。不良的设计将带来严重的工艺问题,而良好的设计可以减少元件间距变小和焊盘尺寸变小带来的负面影响。图2是某公司设计的0.5mm间距CSP的焊盘,它采用了阻焊定义焊盘方式,一个重要的目的就是增加焊膏的量。

图2:0.5mm间距CSP的焊盘及阻焊设计
无铅工艺条件下,必须重视焊膏的选型问题
无铅焊膏目前还存在着一些不足。事实上,焊膏供应商也一直在努力改进焊膏的配方以解决无铅焊接存在的一些特殊问题,如BGA焊接的球窝现象、焊剂飞溅、0201焊点表面粗糙等问题,如图3所示。然而目前还没有一种焊膏可以同时解决这些问题,生产中必须根据产品特性和焊接工艺,有针对性的选用合适的焊膏。
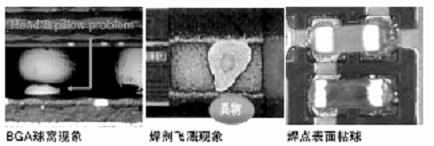
图3:无铅工艺常见问题
对QFP类器件,必须准确定位众所周知,QFP类器件的自对中功能比较差,特别是在无铅焊接工艺条件下更差。对细间距的QFP来说,如果不能实现自对中,贴片偏位实际上就减少了引脚间的间隙,增加了连锡的风险,如图4所示。